
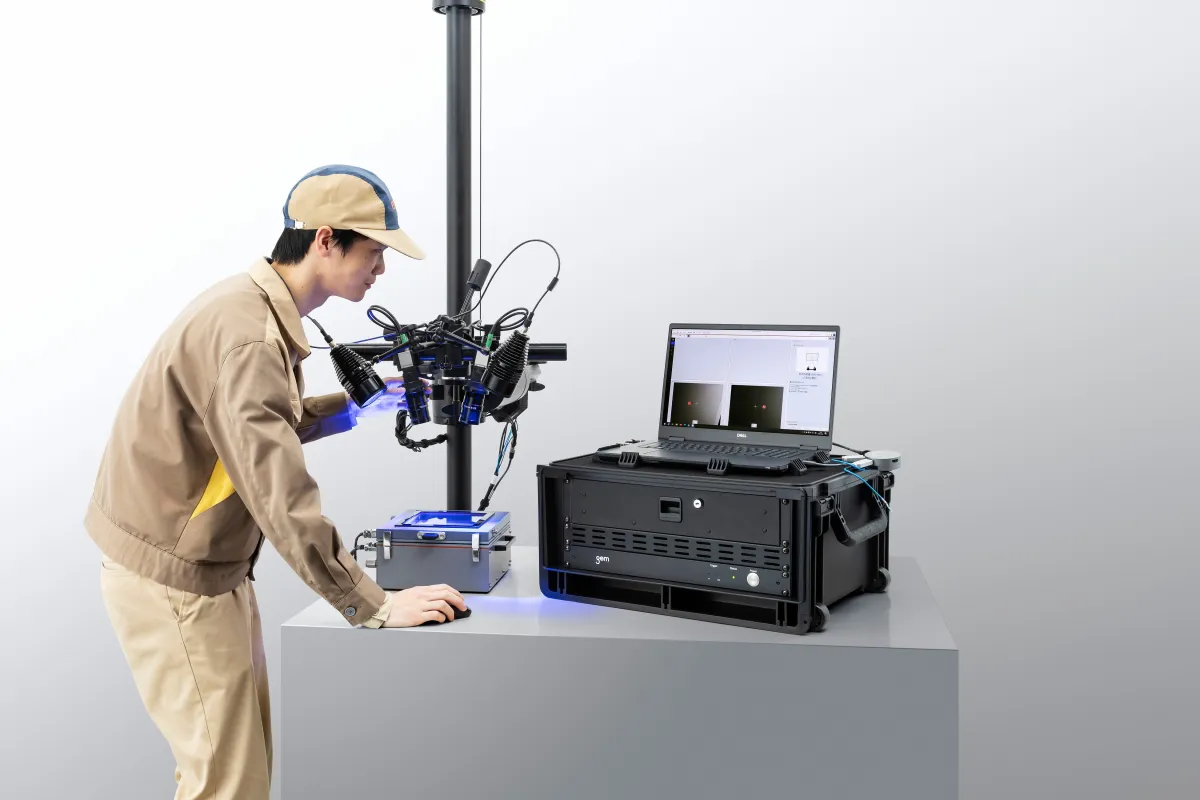
エスペックが新たに基板反りのCAE解析サービスを開始暖かく見守る最先端技術
エスペックが提供する基板反りCAE解析の妥当性確認サービス
日本のエスペック株式会社が2025年12月から新たに提供する「熱変形・熱画像データを用いた基板反りCAE解析結果の妥当性確認サービス」は、半導体パッケージや電子実装基板の信頼性向上を目指しています。このサービスは、電子機器の開発と設計過程において現れる熱的なストレスを分析し、評価期間を短縮することが期待されています。
近年、CAE(Computer Aided Engineering)技術が急速に進化し、それに伴って信頼性解析の重要性も高まっています。特に、AIや電気自動車、データセンターにおける半導体パッケージや基板では、多くの微細配線が用いられており、周辺環境の変化による故障リスクが増加しています。このような状況下で、熱膨張や収縮による反りをデジタルでシミュレーションして、設計の妥当性を確認するCAE解析が重宝されています。
しかし、CAE解析には誤差が伴うため、結果の妥当性確認が非常に重要です。材料データに潜む誤差や解析条件の設定など、さまざまな要因が結果に影響を与えます。エスペックは、この課題を解決するため、CAEのリーダー企業であるサイバネットシステム株式会社と協力し、新たなサービスを構築しました。
このサービスでは、エスペックが開発した計測システムを使用し、熱変形や熱画像データを収集します。得られたデータをもとに、CAE解析条件を検証し、基板反りの解析精度を大幅に向上させることが可能となります。具体的には、熱変形計測システムを介してハードウェアとソフトウェアを連携させ、3次元デジタル画像相関法(3D DIC)やサーモグラフィを用いて、半導体パッケージや電子基板の熱変形を可視化します。
さらに、エスペックはこのサービスの用途を広げており、以下のような具体的な分析を実施します:
- - 2Dおよび3D半導体パッケージ用サブストレートの熱反り変形解析
- - 半導体基板のはんだ接合部における亀裂進展解析
- - エポキシ材やアンダーフィル材など樹脂系材料の挙動解析
この新サービスは、実測データとCAE解析を結合させることで、電子部品における信頼性評価や熱設計、熱対策を強力にバックアップします。また、エスペックは今後も製品とサービスの拡充に力を入れ、次世代半導体や新しい移動手段などの先端技術分野での「熱」に関する課題を解決する一翼を担う所存です。
今後に向けた展望
エスペックの「基板反りCAE解析結果の妥当性確認サービス」は、今後も技術革新を促進し、業界全体の信頼性を高める役割を果たしていくことでしょう。エスペックがこの新たなステージに踏み出すことが、先端技術の実用化を支える大きな一歩となることを期待しています。

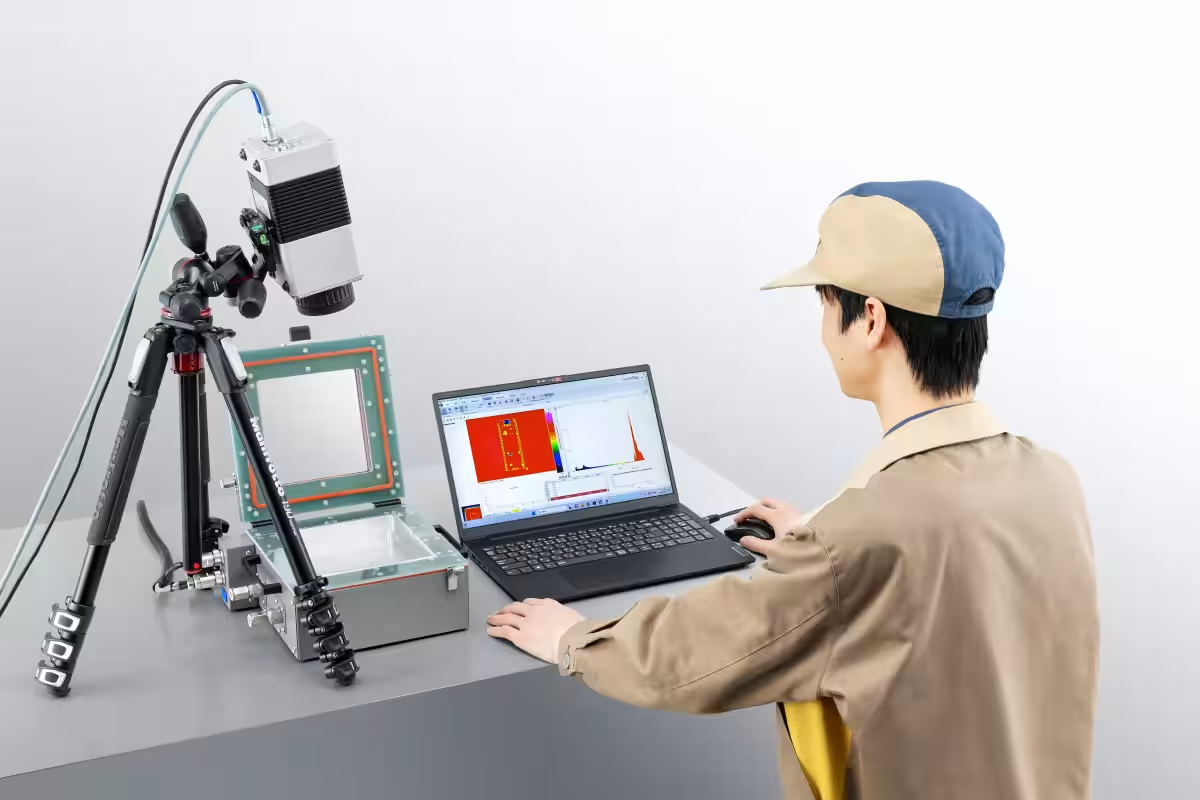
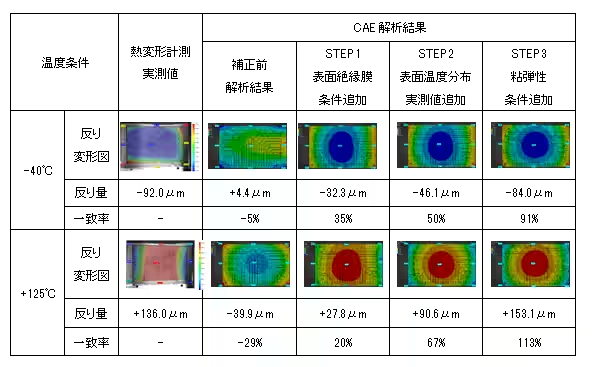
会社情報
- 会社名
- エスペック株式会社
- 住所
- 大阪府大阪市北区天神橋3-5-6
- 電話番号
- 06-6358-4741
トピックス(IT)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。