
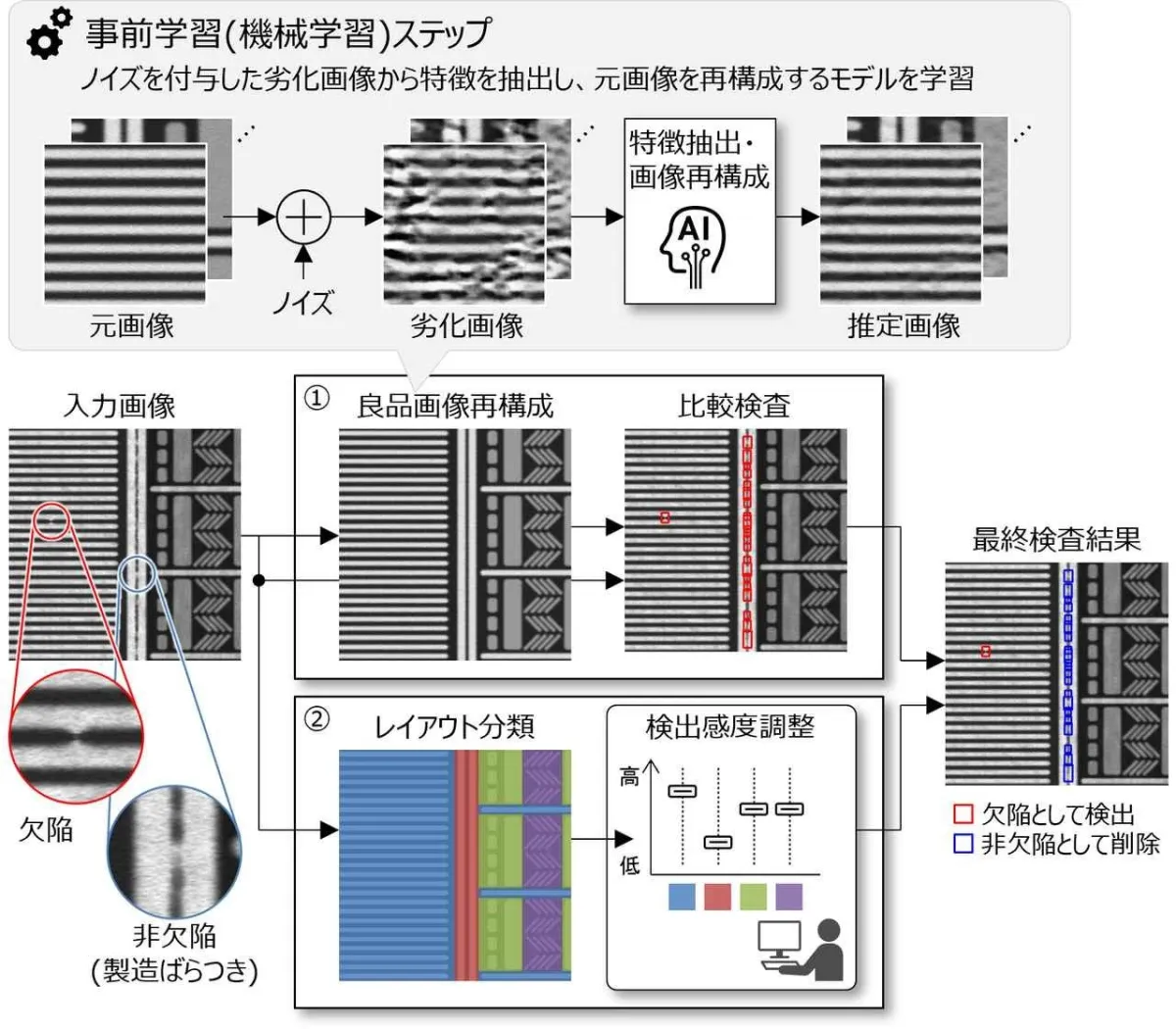
日立が開発した半導体製造向け新技術とは?品質管理の革新を予感
日立が発表した新しい半導体製造技術
日立製作所は、半導体製造プロセスにおける微細欠陥を検出する新しい画像処理技術を開発しました。この技術は、機械学習を活用し、特に10nm以下の微小欠陥を高感度で検出できることが特徴です。半導体デバイスの需要が高まる中、製造プロセスでの品質管理の重要性が増しており、この技術はその要求に応えるものとなっています。
高感度な欠陥検出
新技術は、電子顕微鏡(SEM)を利用し、撮影された画像から微小な欠陥を特定します。日立は、従来の技術で得られた良品画像にノイズを加えた劣化画像を生成し、その中から機械学習を用いて特徴を抽出。これにより、実際の検査では欠陥を含む画像から良品画像を自動で再構成し、再構成前後の差異を比較することで、数画素規模の微細欠陥も検出可能としています。
過検出の問題を解決
欠陥サイズが小さくなるにつれ、製造過程でのばらつきとの判別が難しくなり、過検出の問題が現れます。このため、日立は回路パターンを機械学習で解析し、レイアウトに応じた検出感度の調整を行う技術を開発しました。この技術により、過検出を90%以上抑制することに成功し、製造プロセスの信頼性を向上させました。
今後の展開
日立はこの新技術を通じて、半導体業界における品質管理と生産効率の向上に寄与することを目指しています。さらに、2025年2月23日から27日まで開催される"SPIE Advanced Lithography + Patterning 2025"では、技術の詳細が発表される予定です。
将来的には製造業界のデジタル化、いわゆるDX(デジタルトランスフォーメーション)の進展に寄与するため、日立は引き続き欠陥検査技術を含む画像処理の高度化を進めていくとしています。
半導体業界が抱える品質管理の課題を克服することで、高性能なデバイスの安定した供給が期待されることから、この技術の進展が非常に注目されています。日立は、これからも半導体製造の最前線で挑戦を続けていくことが予想されます。
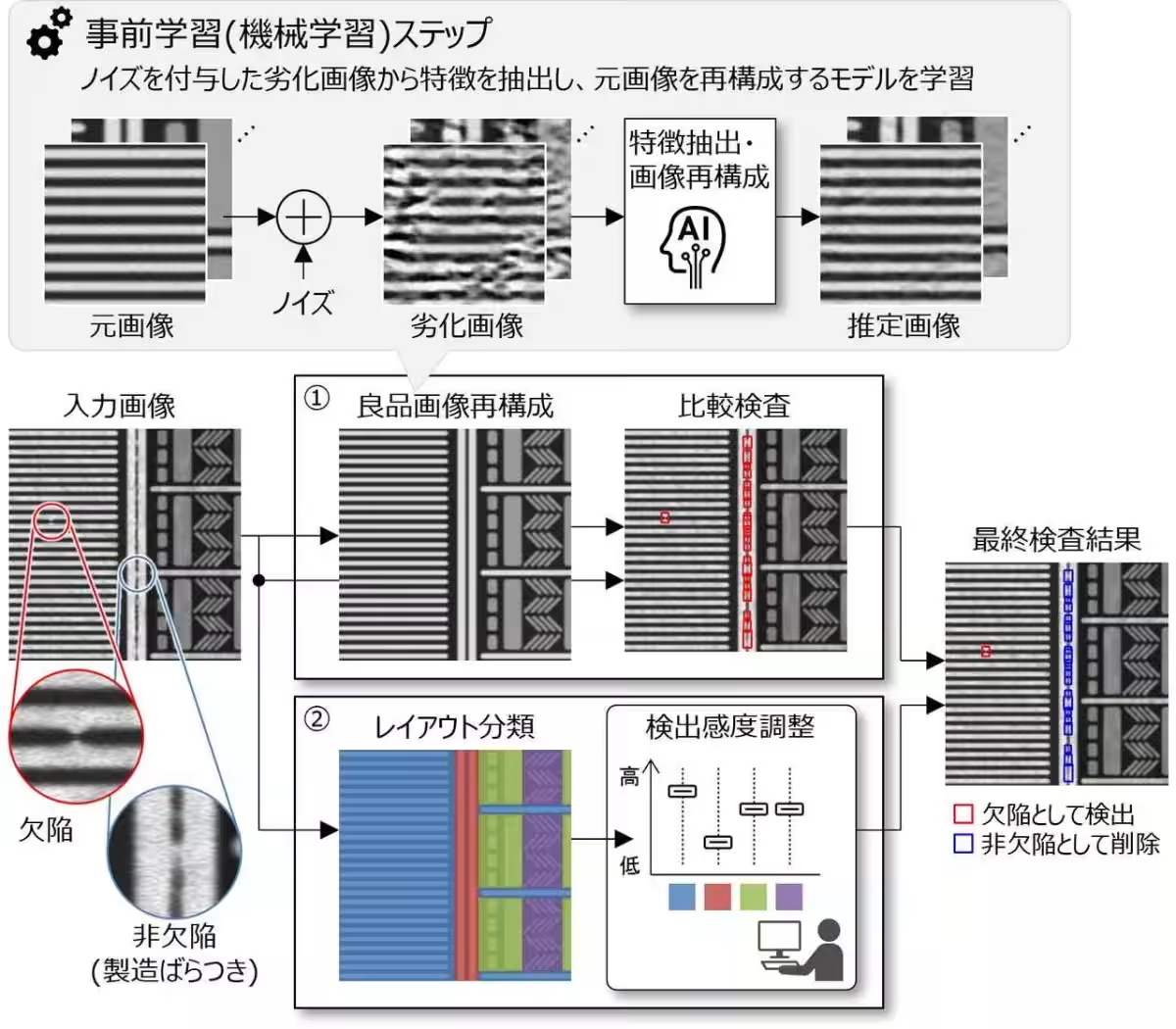
会社情報
- 会社名
- 株式会社 日立製作所
- 住所
- 東京都千代田区丸の内一丁目6番6号
- 電話番号
- 03-3258-1111
トピックス(地域情報)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。