

レゾナックが開発した次世代半導体向け新材料の展望
株式会社レゾナックが新たに開発した半導体向け材料
近年、半導体パッケージの大型化が進む中、基板の反りという課題が顕在化しています。その中で、株式会社レゾナックが極めて先進的な解決策を提供しました。
その名も「低熱膨張銅張積層板」。これは、次世代の半導体パッケージ向けに特別に設計された新しい材料であり、2026年に量産開始を目指しています。
反りの問題とその影響
半導体パッケージ基板が大きくなるにつれ、反りによる信頼性への影響はますます重要な問題となっています。従来、基板の反りを抑えるためには、銅張積層板の熱膨張係数を小さくすることが有効とされてきましたが、これには温度サイクル試験中の冷却時に、他の材料との熱膨張差によるクラック(亀裂)が発生するリスクが伴います。
レゾナックの新技術は、このエ問題を解決するために、「マルチスケール解析」と呼ばれる計算科学技術を活用しています。この手法により、銅張積層板の樹脂やガラスクロスからなるコア層の物性を細かく分析し、応力を効果的に制御できる設計指針が導き出されました。
具体的な技術の応用
このプロジェクトにおいて、レゾナックの計算情報科学研究センターは、銅張積層板の樹脂に加わる局所的な応力を詳細に解析することに成功しました。これにより、樹脂の特定の特性を調整することで、発生する応力を低減した低熱膨張銅張積層板の開発を実現しました。
さらに、レゾナックは汎用的な物性可視化システムを構築し、社内での展開を開始しています。このシステムでは、ユーザーが材料の物性を入力すると、反りなどの目的特性がどのように変化するのかを視覚的に示します。この過程は、銅張積層板以外にもさまざまな製品に適用可能です。
未来に向けた取り組み
レゾナックは、半導体業界における迅速な技術革新の必要性に対応するため、計算情報科学研究センターのリソースの約70%を半導体材料の開発に投じています。これにより、高性能材料を世に送り出し、持続可能なグローバル社会の発展に貢献したいと考えています。
会社概要
株式会社レゾナックは、2023年に昭和電工グループと昭和電工マテリアルズグループが統合して設立された企業です。特に半導体の後工程材料では世界ナンバーワンの地位を誇り、今後も革新的な技術の開発を進めていく所存です。公式ウェブサイトでは、さらなる情報を提供していますので、興味のある方はぜひ訪れてみてください。


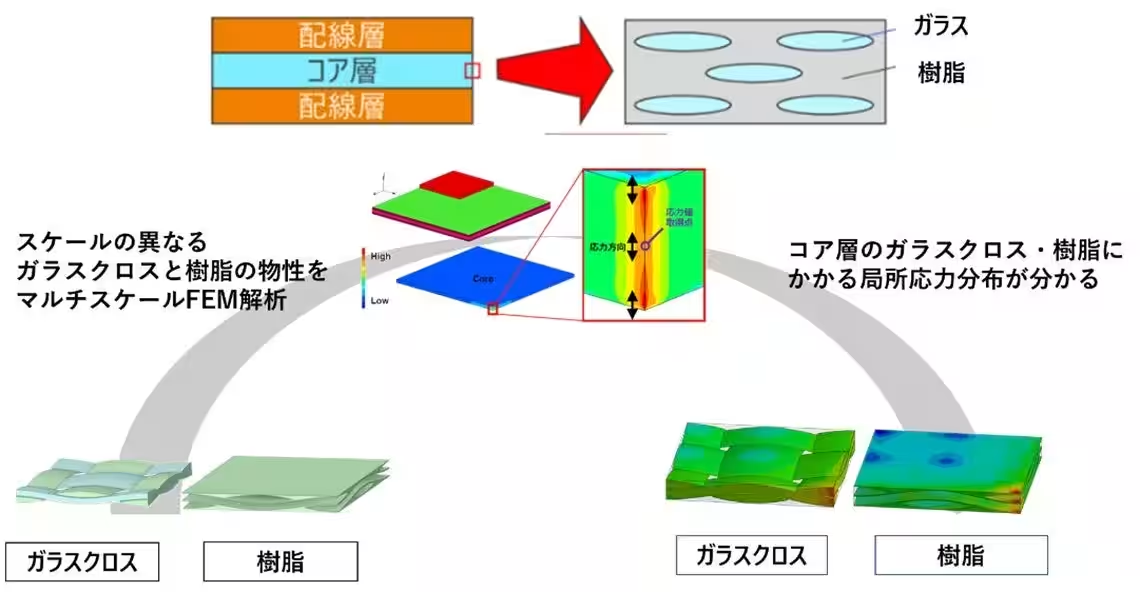
会社情報
- 会社名
- 株式会社レゾナック・ホールディングス
- 住所
- 東京都港区東新橋1-9-1 東京汐留ビルディング
- 電話番号
- 03-5470-3235
トピックス(IT)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。