
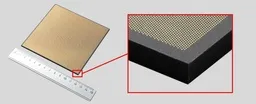
京セラ、AIデータセンター向け多層セラミック基板の開発を進行中
京セラがAIデータセンター向けの新基板開発を発表
京セラ株式会社は、AIデータセンターのニーズに応じた多層セラミックコア基板の開発に取り組んでいます。この基板は、特にxPUやスイッチASICなどの先端半導体パッケージ向けです。データセンターの高度化と大型化が進んでいる中で、京セラは高密度配線が可能で、反りを低減する特長を持つ独自のセラミック材料を活用しています。
開発の背景
最近、生成AIや大規模言語モデルの普及が進み、データセンターの新設や拡張が世界的に加速しています。この新しい時代において、xPUやスイッチ用ASICといった先端半導体は、高速で大容量の通信が求められています。そのため、パッケージ基板の大型化や高密度配線が重要な課題となっています。
従来の有機コア基板では、反りの低減や微細配線の実現が難しくなっており、これを解決するために京セラは、これまでの積層セラミックパッケージで培った技術を生かして新たな基板の開発を進めています。
主な特長
1. 高剛性による反りの低減
この新しい多層セラミックコア基板は、従来の有機コア基板に比べて高い剛性を持っており、曲げ強度も優れています。これにより、実装プロセス中の反りを大幅に減少させることができ、薄型化にも寄与します。
2. 微細な配線技術
セラミック基板では、ビアと呼ばれる電気的接続を行うための導体が設置されます。京セラの新技術では、柔らかい状態で加工するプロセスを採用しており、従来のドリル加工法よりも高い微細加工性を持っています。これにより、小径化や狭ピッチ化を実現し、高密度配線の課題を克服しました。
3. カスタム設計とシミュレーションサポート
京セラは、顧客のニーズに合わせたカスタム設計提案を行い、熱応力や電気シミュレーション、基板反りシミュレーションも提供します。これらのシミュレーション結果を用いて、より効率的なデバイス設計を実現します。
展示予定
この多層セラミックコア基板は、2026年5月26日から29日までアメリカ・オーランドで開催される国際学会「ECTC2026」にて展示される予定です。この学会では、半導体パッケージング技術に関する最新の研究成果が発表され、多くの専門家たちが集まる場となります。
京セラは今後も、様々なニーズに応じた材料や技術の開発を続け、半導体産業の発展に貢献していく方針です。この新たな多層セラミックコア基板の商用化が進むことで、AIデータセンターの技術革新がさらに促進されることが期待されています。
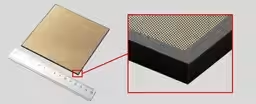

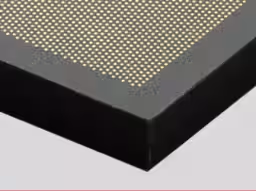

会社情報
- 会社名
- 京セラ
- 住所
- 電話番号
トピックス(IT)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。