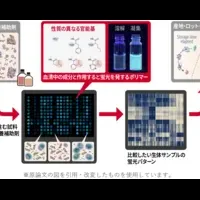

ニューフレアテクノロジーがSPIEで先進的な露光技術を発表
ニューフレアテクノロジーが国際会議で新技術を発表
2026年2月22日から26日まで、カリフォルニア州サンノゼ市では、「SPIE Advanced Lithography + Patterning」という国際会議が開催され、多くの企業や研究者が参加しました。この会議は光学やフォトニクスの分野に特化したもので、毎年多くの技術的革新を紹介する場となっています。
株式会社ニューフレアテクノロジー(NFT)は、同会議に参加し、最新のマルチ電子ビームマスク描画装置に関する研究成果を発表しました。特に、ウェハ露光技術やフォトマスク製作に関する幅広いテーマが取り上げられ、ブレークスルーな技術や進展が多くの関心を集めました。NFTは、計3件の発表を行っており、そのうち1件は共著者としての参加です。
発表内容
1. Invited Paper: MBM-4000の先進機能と応用
NFTからの特別講演として行われた「Paper 13982-17」では、マルチ電子ビームマスク描画装置であるMBM-4000の先進的な機能と、その応用範囲について深い考察がなされました。基調講演者は藤原裕司氏で、同装置がもたらす可能性や使用シーンについて具体的なデータをもとに説明しました。
2. パターン忠実度評価に関する分析
続いて、川野誠氏による「Paper 13981-114」では、電子マルチビームマスク描画におけるサイン波パターンを用いたパターン忠実度評価の影響要因についての分析が行われました。この発表では、各要因がパターンの精度や質に与える影響について、実験結果をもとに詳細に考察が行われ、参加者の関心を引きました。
参加者の反応と新たな展望
会議では、NFTのブースにも多くの訪問者が集まり、技術に対する質問や意見交換が活発に行われました。このような場を通じて、NFTは業界内での位置づけをさらに強化し、新たなビジネスチャンスを模索しています。また、同社の技術が今後の半導体産業に与える影響に熱い視線が注がれています。
今回の参加は、NFTにとって重要なアピールの場となり、将来的にはさらなる技術革新が期待されます。半導体製造の進化に貢献するため、NFTは今後も技術開発に注力し、業界をリードしていく方針です。技術者同士のネットワーク形成も重要であり、この会議がその一助となることを期待しています。今後のNYFTの動向からますます目が離せません。

会社情報
- 会社名
- 株式会社ニューフレアテクノロジー
- 住所
- 神奈川県横浜市磯子区新杉田町8番1
- 電話番号
トピックス(科学)
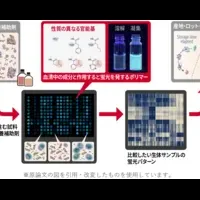

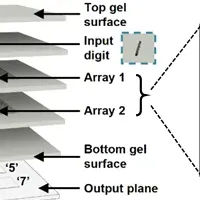







【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。