
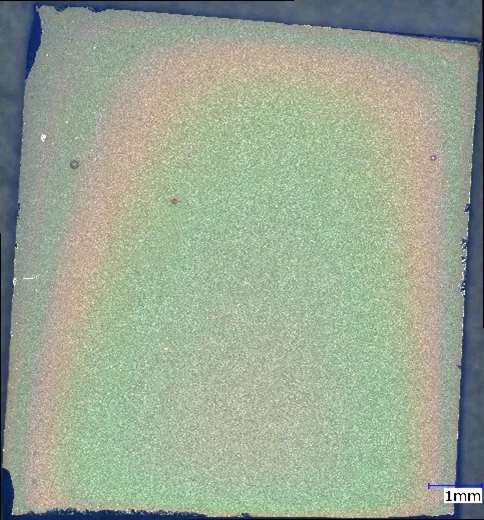
次世代半導体材料r-GeO₂のSi基板上での薄膜作製成功の意義
次世代半導体材料r-GeO₂の薄膜化に成功
Patentix株式会社は、次世代パワー半導体材料として注目されるルチル型二酸化ゲルマニウム(r-GeO₂)の薄膜をシリコン(Si)基板上に作製することに成功しました。この成果は、高性能かつコスト効率の良い次世代半導体を実現するための重要な一歩となるでしょう。
背景と半導体産業の現状
これまで、パワー半導体の基板としてはコストが低いシリコン(Si)が広く用いられてきました。しかし、Si製パワーデバイスはその性能の限界に直面しており、業界ではバンドギャップが大きいシリコンカーバイド(SiC)や窒化ガリウム(GaN)へと移行が進んでいます。これらはバンドギャップがそれぞれ3.3 eVと3.4 eVなのに対し、r-GeO₂はさらに大きな4.68 eVというバンドギャップを持ち、p型・n型の両方の伝導が可能とされています。
r-GeO₂薄膜作製の技術
Patentixは、独自に開発したPhantom SVD(ファントム局所的気相成長)法を用い、これまでにTiO₂基板やSiC基板上への高品質r-GeO₂薄膜の成膜を成功させています。この技術は、シリコン基板上においても非常に重要です。SiCの製造工程はコストがかかるため、プロジェクトの継続性が求められています。その点、r-GeO₂は安価なSi基板上でのヘテロエピ成長が可能になるため、コスト競争力が期待されます。
成果の具体的な内容
今回、PatentixはSi(100)基板上に導電性バッファー層を成膜し、その上にr-GeO₂の結晶膜を成功裏に成膜したことを発表しました。これは世界初の快挙です。測定したX線回折(XRD)プロファイルからは、r-GeO₂由来の明瞭なピークが確認され、バッファー層の採用により、主流の縦型構造のデバイス作製が簡便になることも示されました。
未来への展望
Patentixは、GeO₂ on Si基板を用いたパワーデバイスを市場に投入し、SiCパワー半導体の市場に挑戦していく構えです。今回の成果は、Si基板上でのr-GeO₂薄膜が高性能な次世代半導体材料として実現可能であることを示しています。今後は、さらなる高品質化や大口径基板の開発を進め、GeO₂ on Si基板の製品化を加速させる方針です。これにより、より手ごろで高性能なパワー半導体の実現が期待されます。
今回の成功を足掛かりに、業界全体での技術革新へとつながることを願っています。
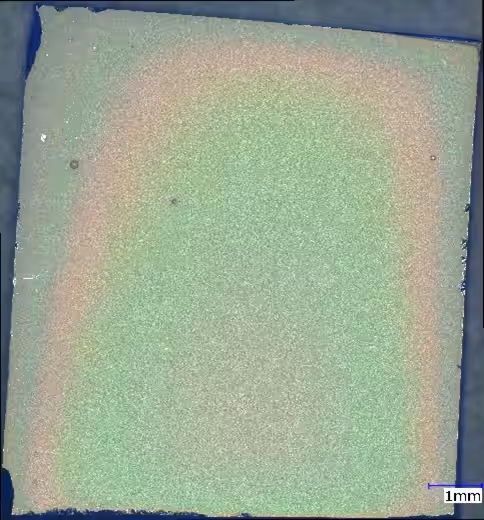

会社情報
- 会社名
- Patentix株式会社
- 住所
- 滋賀県草津市野路東1丁目1番1号立命館大学BKCインキュベータ
- 電話番号
- 0775-99-1558
トピックス(エンタメ)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。