

半導体パッケージングの全貌を解説した新刊が登場!
半導体パッケージングと実装技術のすべて
半導体技術は進化を続けており、最新の業界動向を把握するには、信頼できる参考書が不可欠です。2025年9月10日に出版される新刊『半導体パッケージングと実装技術のすべて』は、半導体後工程に特化した内容で、基礎から応用まで幅広く学べる重要な一冊です。この本は、特に注目されている2.5Dおよび3Dパッケージング技術や先進的なチップレット技術について詳述されています。
著者である蛭牟田要介氏は、長年にわたる半導体業界での豊富な経験を基に、実践的な知識や具体的な不具合の事例を交えながら、テクノロジーの発展を解説します。本書の目標は、半導体パッケージングの重要性を理解し、将来の技術動向を見据えることにあります。
本書の特徴
- - 基礎から応用までの丁寧な解説:半導体製造の後工程における技術とプロセスを系統的に解説。
- - 実践的な知識提供:著者の経験に基づく具体的な事例や、不具合の解析手法を紹介。
- - 環境規制への対応:RoHSやPFASへの取り組みなど、現代の環境問題に向けた技術的アプローチを含む。
半導体パッケージングの進化
半導体は、現代社会において不可欠な存在です。私たちの日常生活において、スマートフォンやIoT機器、自動車に至るまで、半導体技術は広がっています。半導体の製造プロセスは、2nmの微細化を実現する一方で、性能を最大限に引き出すための「チップレット」技術へのシフトが進んでいます。これは、半導体業界に大きな影響を与えています。
本書では、かつて単なる「入れ物」としての役割だったパッケージが、高機能、小型化を果たし、多様化してきた経緯が詳しく解説されています。DIP、QFP、BGAといったさまざまな形式が登場し、業界のニーズに応えています。赤字にならないための進化の歴史は、技術者や研究者にとって非常に興味深い内容です。
実践的な知識の重要性
著者は、現場での経験をふまえた具体的な失敗例や教訓を紹介し、理論だけでは得られない実践的な知識がどのように業務に役立つかを解説します。例えば、チップクラックやワイヤー断線といった具体的なトラブルは、技術者にとって重要な情報です。企業の品質向上や信頼性確保に向けた施策を理解する上でも、本書は大いに役立つでしょう。
未来の技術トレンド
環境問題に配慮した品質基準や、最新の技術トレンドに対する理解を深めることも、この本の重要なポイントです。2.5D/3Dパッケージングやチップレット技術について詳細に探求し、それが今後の半導体業界にどのように影響を与えるかについても触れられています。
若手技術者や学生をはじめ、新たに半導体パッケージングを学びたい方々にとって、求められる専門知識を得るための羅針盤として、『半導体パッケージングと実装技術のすべて』は価値ある一冊です。技術者たちが自身のキャリアを進展させる手助けをしてくれることでしょう。これからの半導体市場での競争力をつけるために、是非手に取ってみてください。

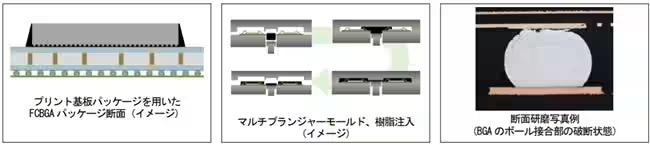
会社情報
- 会社名
- 株式会社シーエムシー・リサーチ
- 住所
- 東京都千代田区神田錦町2-7東和錦町ビル3階
- 電話番号
- 03-3293-7053
トピックス(IT)










【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。