
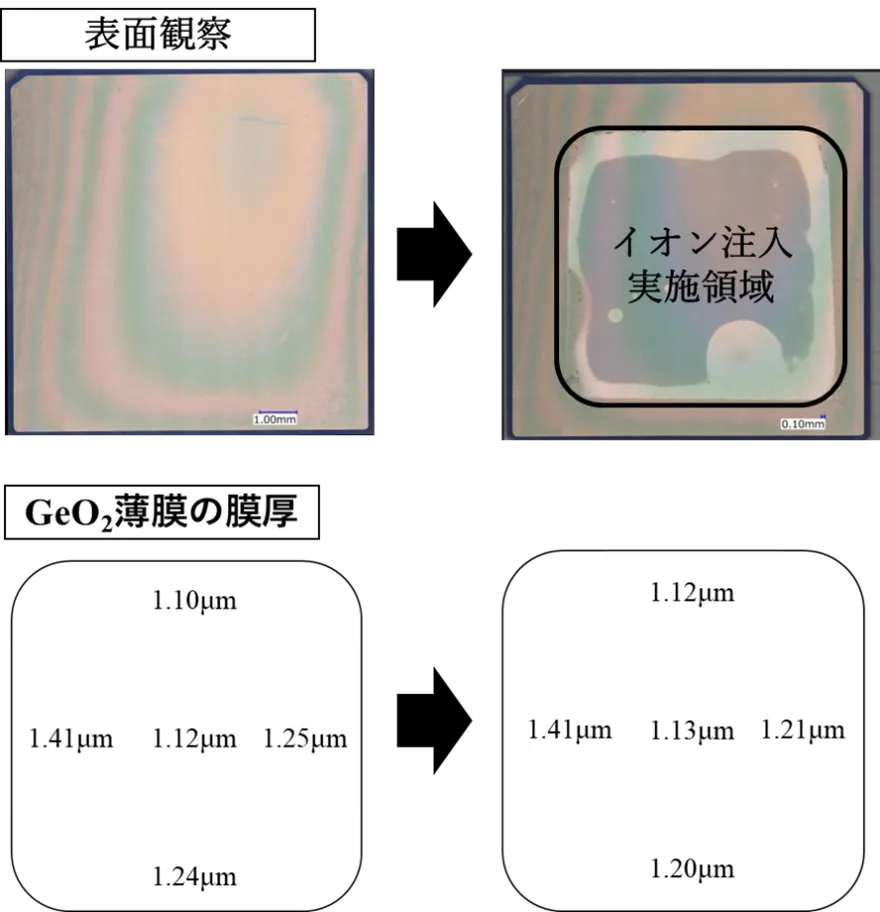
r-GeO₂半導体におけるn型導電性付与の新技術開発
r-GeO₂半導体におけるイオン注入によるn型導電性の付与
Patentix株式会社は、次世代のパワー半導体材料として注目を集めるルチル型二酸化ゲルマニウム(r-GeO₂)にイオン注入技術を用いて、初めてn型の導電性を付与することに成功しました。この新技術は、パワーMOSFETなどの複雑なパワーデバイスの開発を加速させる可能性があります。
1. r-GeO₂とは
ルチル型二酸化ゲルマニウム(r-GeO₂)は、炭化ケイ素(SiC)や窒化ガリウム(GaN)といった従来の半導体材料に対抗する新しい選択肢として注目されています。これらの材料と比べ、r-GeO₂は約4.68eVの大きなバンドギャップを持ち、理論上はp型・n型両方の導電性を調整できる可能性があります。この特性により、さまざまな高耐圧・高出力・高効率な半導体デバイスの実現が期待されています。
2. イオン注入技術の導入
Patentixは、以前にPhantomSVD法という独自の成膜技術を用いて、ドナー不純物(アンチモン:Sb)を利用したn型導電性の制御に成功しています。この過程においては、約1020[cm-3]の電子密度を持つr-GeO₂薄膜を作成しました。しかし、パワーデバイスの製造にはより精密なドーピング技術が求められ、イオン注入による方式が希望されていました。
3. 成果
新たに開発したイオン注入プロセスにより、r-GeO₂薄膜にSbを導入し、シート抵抗が低下することが確認されました。これにより、r-GeO₂の絶縁性を保ちながらn型の導電性が付与されました。また、C-V測定も行ったところ、イオン注入された領域にn型導電性が見られ、これがドナー不純物の効果であることが明らかになりました。今後は、Sbがどの程度導入されているのかを詳しく調査していく予定です。
4. 将来展望
今後、Patentixはr-GeO₂を使用したパワーデバイスの実用化に向けて、イオン注入プロセスの条件最適化や新たな試作を進めていく見通しです。この技術が進展すれば、脱炭素社会の実現に向けた新たなステップとなることでしょう。先日、応用物理学会で発表する予定の研究成果も、ぜひご注目ください。
Patentix株式会社は、革新的な半導体材料の開発を通じて、持続可能な未来の実現に向けた貢献を目指しています。我々の技術革新が、電力消費を効率化し、環境に配慮した社会の実現に寄与することを願っています。
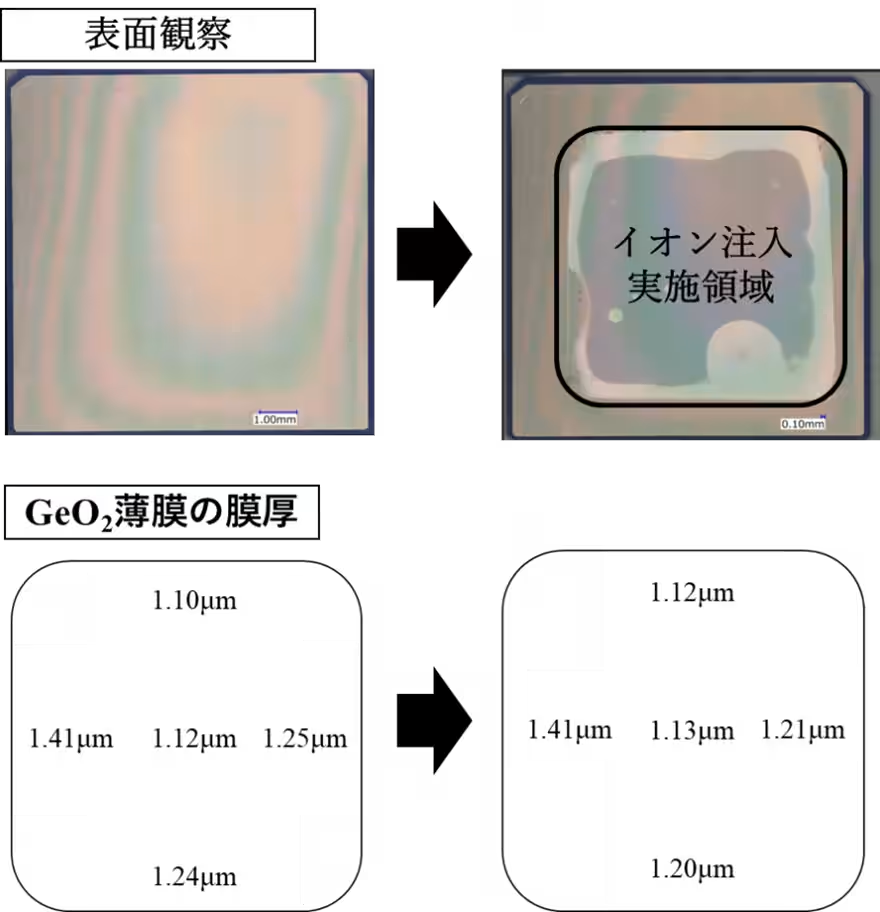
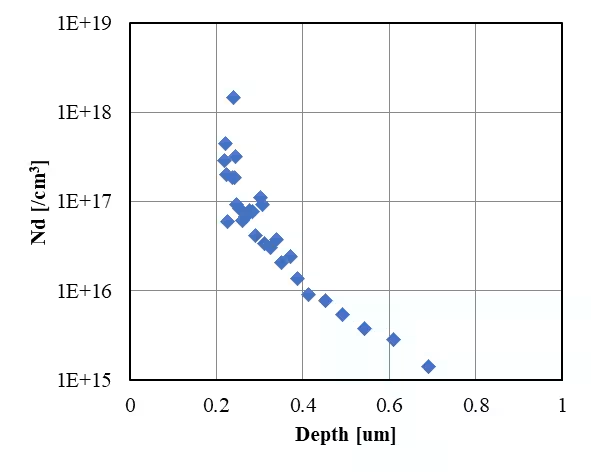
会社情報
- 会社名
- Patentix株式会社
- 住所
- 滋賀県草津市野路東1丁目1番1号立命館大学BKCインキュベータ
- 電話番号
- 0775-99-1558
トピックス(科学)






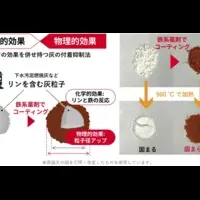



【記事の利用について】
タイトルと記事文章は、記事のあるページにリンクを張っていただければ、無料で利用できます。
※画像は、利用できませんのでご注意ください。
【リンクついて】
リンクフリーです。